今天小编要和大家分享的是雪崩光电探测器材料 雪崩光电探测器芯片结构,接下来我将从雪崩光电探测器的材料,雪崩光电探测器的芯片结构,雪崩光电探测器结构和能带,这几个方面来介绍。

光电探测器是将光信号转变为电信号的器件,雪崩光电探测器采用的即是雪崩光电二极管(APD),能够具有更大的响应度。APD将主要应用于长距离或接收光功率受到其它限制而较小的光纤通信系统。目前很多光器件专家对APD的前景十分看好,认为APD的研究对于增强相关领域的国际竞争力,是十分必要的。
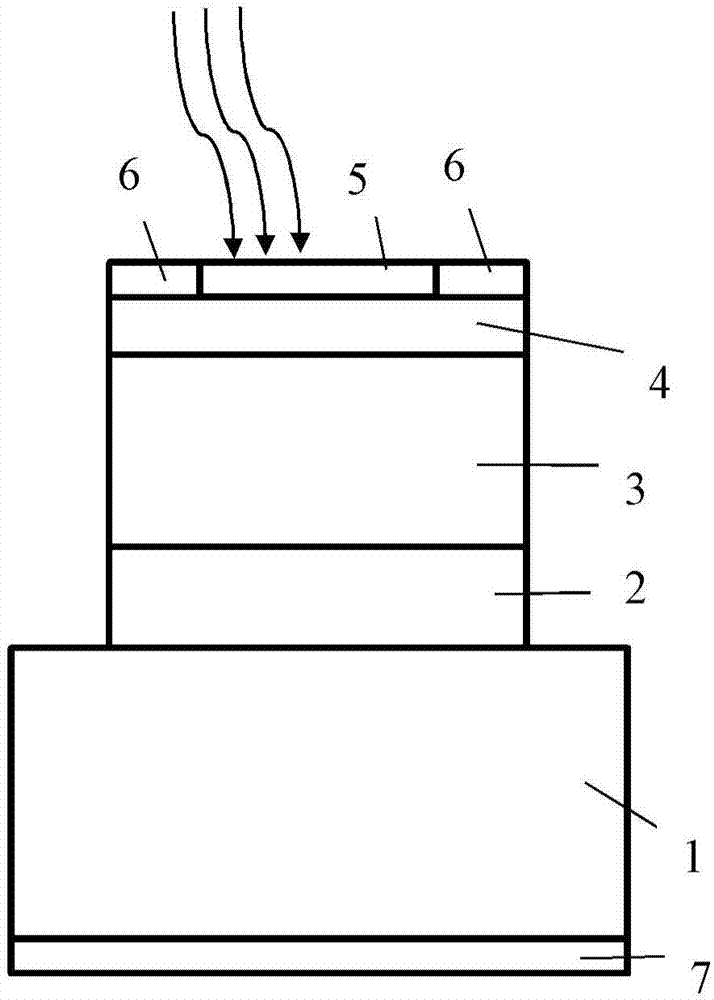
雪崩光电探测器的材料
1)Si
Si材料技术是一种成熟技术,广泛应用于微电子领域,但并不适合制备目前光通信领域普遍接受的1.31mm,1.55mm波长范围的器件。
2)Ge
GeApD虽然光谱响应适合光纤传输低损耗、低色散的要求,但在制备工艺中存在很大的困难。而且,Ge的电子和空穴的离化率比率()接近1,因此很难制备出高性能的ApD器件。
3)In0.53Ga0.47As/Inp
选择In0.53Ga0.47As作为ApD的光吸收层,Inp作为倍增层,是一种比较有效的方法[2]。In0.53Ga0.47As材料的吸收峰值在1.65mm,在1.31mm,1.55mm波长有约为104cm-1高吸收系数,是目前光探测器吸收层首选材料。In0.53Ga0.47As光电二极管比起Ge光电二极管,有如下优点:(1)In0.53Ga0.47As是直接带隙半导体,吸收系数高;(2)In0.53Ga0.47As介电常数比Ge小,要得到与Ge光电二极管相同的量子效率和电容,可以减少In0.53Ga0.47As耗尽层的厚度,因此可以预期In0.53Ga0.47As/Inp光二极管具有高的效应和响应;(3)电子和空穴的离化率比率()不是1,也就是说In0.53Ga0.47As/InpApD噪声较低;(4)In0.53Ga0.47As与Inp晶格完全匹配,用MOCVD方法在Inp衬底上可以生长出高质量的In0.53Ga0.47As外延层,可以显着的降低通过p-n结的暗电流。(5)In0.53Ga0.47As/Inp异质结构外延技术,很容易在吸收区生长较高带隙的窗口层,由此可以消除表面复合对量子效率的影响。
4)InGaAsp/Inp
选择InGaAsp作为光吸收层,Inp作为倍增层,可以制备响应波长在1-1.4mm,高量子效率,低暗电流,高雪崩增益得的ApD。通过选择不同的合金组分,满足对特定波长的最佳性能。
)InGaAs/InAlAs
In0.52Al0.48As材料带隙宽(1.47eV),在1.55mm波长范围不吸收,有证据显示,薄In0.52Al0.48As外延层在纯电子注入的条件下,作为倍增层材料,可以获得比Inp更好的增益特性。
6)InGaAs/InGaAs(p)/InAlAs和InGaAs/In(Al)GaAs/InAlAs
材料的碰撞离化率是影响ApD性能的重要因素。研究表明[6],可以通过引入InGaAs(p)/InAlAs和In(Al)GaAs/InAlAs超晶格结构提高倍增层的碰撞离化率。应用超晶格结构这一能带工程可以人为控制导带和价带值间的非对称性带边不连续性,并保证导带不连续性远远大于价带不连续性(ΔEc>>ΔEv)。与InGaAs体材料相比,InGaAs/InAlAs量子阱电子离化率(a)明显增加,电子和空穴获得了额外能量,由于ΔEc>>ΔEv,可以预期电子所获得的能量使电子离化率的增加量远远大于空穴能量对空穴离化率(b)的贡献,电子离化率与空穴离化率的比率(k)增加。因此,应用超晶格结构可以获得大的增益-带宽积(GBW)和低噪声性能。然而,这种可以使k值增加的InGaAs/InAlAs量子阱结构ApD很难应用在光接收机上。这是因为影响最大响应度的倍增因子受限于暗电流,而不是倍增噪声。在此结构中,暗电流主要是由窄带隙的InGaAs阱层的隧道效应引起,因此,引入宽带隙的四元合金,比如InGaAsp或InAlGaAs,代替InGaAs作为量子阱结构的阱层可以抑制暗电流。
在相同的电场下,超晶格结构可以大大提高k,表明超晶格结构的器件具有更大的信噪比。研究表明,InAlGaAs/InAlAs量子阱结构的平均能隙为1.32eV,InAlGaAs和InAlAs的带隙值分别为1.13eV和1.47eV,量子阱结构的能隙值介于InAlGaAs和InAlAs的带隙值之间。量子阱结构的空穴离化率近似等于InAlGaAs和InAlAs空穴离化率的平均值,因此InAlGaAs/InAlAs结构的空穴离化率可以用带隙差来很好的解释。然而对于电子离化率来说,量子阱结构比InAlGaAs和InAlAs的值都大。这种差异表明电子碰撞离化率的增加是由于大的导带差(ΔEc)引起的。在InGaAsp/InAlAs异质结中,这种大的导带差更为明显,而价带的差异通过p的引入几乎消失,预期InGaAsp/InAlAsApD具有更大的电子碰撞离化率。
雪崩光电探测器的芯片结构
合理的芯片结构是高性能器件的基本保证。ApD结构设计主要考虑RC时间常数,在异质结界面的空穴俘获,载流子通过耗尽区的渡越时间等因素。下面对其结构的发展作一综述:
1)基本结构
最简单的ApD结构是在pIN光电二极管的基础上,对p区和N区都进行了重掺杂,在邻近p区或N区引进n型或p型倍憎区,以产生二次电子和空穴对,从而实现对一次光电流的放大作用。对于Inp系列材料来说,由于空穴碰撞电离系数大于电子碰撞电离系数,通常将N型掺杂的增益区置于p区的位置。在理想情况下,只有空穴注入到增益区,所以称这种结构为空穴注入型结构。
2)吸收和增益区分开
由于Inp宽带隙特性(Inp为1.35eV,InGaAs为0.75eV),通常以Inp为增益区材料,InGaAs为吸收区材料。
3)分别吸收、渐变、增益(SAGM)结构的提出
目前商品化的ApD器件大都采用Inp/InGaAs材料,InGaAs作为吸收层,Inp在较高电场下(>5x105V/cm)下而不被击穿,可以作为增益区材料。对于该材料,所以这种ApD的设计是雪崩过程由空穴碰撞而在n型Inp中形成。考虑到Inp和InGaAs的带隙差别较大,价带上大约0.4eV的能级差使得在InGaAs吸收层中产生的空穴,在达到Inp倍增层之前在异质结边缘受到阻碍而速度大大减少,从而这种ApD的响应时间长,带宽很窄。这个问题可以在两种材料之间加InGaAsp过渡层而得到解决。
4)分别吸收、渐变、电荷和增益(SAGCM)结构的提出
为了进一步调节吸收层和增益层的电场分布,在器件设计中引入了电荷层,这种改进大大的提高了器件速率和响应度。
5)谐振腔增强型(RCE)SAGCM结构
在以上传统探测器的优化设计中,必须面临这样一个事实:即吸收层的厚度对器件速率和量子效率是一个矛盾的因素。薄的吸收层厚度可以减少载流子渡越时间,因此可以获得大的带宽;然而,同时为了得到更高的量子效率,需要吸收层具有足够的厚度。解决这个问题可以采用谐振腔(RCE)结构,即在器件的底部和顶部设计DBR(distribudBraggReflector)。这种DBR反射镜在结构上包括低折射率和高折射率的两种材料,二者交替生长,各层厚度满足在半导体中入射光波长的1/4。这种谐振腔结构的探测器在满足速率要求的前提下,吸收层厚度可以做得很薄,而且电子在经过多次反射后,量子效率增加。
由于GaAs/AlAs谐振腔工艺的成熟,目前这种结构的器件以GaAs/AlGaAs材料为最多,增益-带宽积300GHz以上。Inp/InGaAs谐振腔由于Inp和InGaAs两种材料折射率差较小,使得工艺变得复杂,因此以Inp为基材料的谐振腔增强型探测器实用化的很少。当然可以利用键合技术,应用GaAs/AlAs的成熟工艺,制备以Inp为基材料的谐振腔增强型探测器。近年来又出现了以InAlGaAs/InAlAs或者InGaAs(p)/InAlAs材料的DBR,其波长位于我们感兴趣的波长范围,受到研究和开发人员的广泛关注。用MBE(分子束外延)生长的器件结构包括半绝缘的Inp衬底,DBR反射镜(30对各层厚度为λ/4的InGaAs/InAlAs),未掺杂的InAlAs倍增层,p型掺杂的InAlAs电荷层,电荷层的作用是确保60nm厚的InAlAs吸收层的电场不高于105V/cm,保证器件高速率特性。最后生长的是未掺杂的InAlAs空间层和p+-InAlAs顶层,其厚度都进行了优化设计以确保器件在特定波长都具有最高的响应度。
这种结构的器件可以获得小于10nA的低暗电流,在单位增益的条件下,可以获得70%的峰值量子效率。噪声测量表明该器件具有非常低的噪声特性(k~0.18),这个值比以Inp为基材料的ApD高很多,显示了InAlAs系列材料在低噪声器件方面的巨大潜力。
6)边耦合的波导结构(WG-ApD)
另一种解决吸收层厚度对器件速率和量子效率不同影响的矛盾的方案是引入边耦合波导结构。这种结构从侧面进光,因为吸收层很长,容易获得高量子效率,同时,吸收层可以做得很薄,降低载流子得渡越时间。因此,这种结构解决了带宽和效率对吸收层厚度的不同依赖关系,有望实现高速率,高量子效率的ApD。WG-ApD在工艺上较RCEApD简单,省去了DBR反射镜的复杂制备工艺。因此,在实用化领域更具有可行性,适用于共平面光连接。
图5给出了InGaAs/InAlAsSACMWG-ApD结构示意图[12]。该器件是用MOCVD方法,在S-掺杂的(100)Inp衬底上,生长100nmN型Inp过渡层,再生长一层N-型InAlAs层。150nm的倍增层是采用非故意掺杂的InAlAs材料。Zn掺杂浓度为2.1×1017cm-3的180nm电荷层的作用是调整电场在吸收层和倍增层的分配,吸收层上下两侧各生长100nm非故意掺杂的InAlGaAs波导层。这种结构的器件可以实现320GHz的增益-带宽积和极低的噪声特性(k=0.15),充分表现了其在高速率和长距离光通信领域的潜在应用。
WG-ApD的主要问题是薄的吸收层厚度减少了光耦合效率,而且,由于切片工艺和在进光面抗反膜的影响,使这种结构的器件可能性变差。这些问题可以通过结构改进而逐步解决。
雪崩光电探测器结构和能带
在波长为1.55gm的长波长区域,由于锗光电探测器遇到暗电流较大等问题,人们便转向使用Inp基材料。在Inp衬底上生长InGaAsp,通过调整化合物组分含量使它能在1.2~1.6gm波长范围内工作。图1所示是最早出现的InGaAsp/Inp雪崩光电探测器结构和能带示意图LZII。在p+-Inp上生长n-InGaAsp,再通过衬底注入锌形成InGaAsp的pn结,最后覆盖一层n-Inp。这种衬底和表面层都是宽禁带低阻层结构减小了串联,阻止了光生载流子向表面扩散引起的复合。
关于雪崩光电探测器,电子元器件资料就介绍完了,您有什么想法可以联系小编。